-
首页
-
产品中心
-

HOTFLOW 3/20
-

HOTFLOW 3/26 XL
-

选择性焊接系统 VERSAFLOW 3/45
-
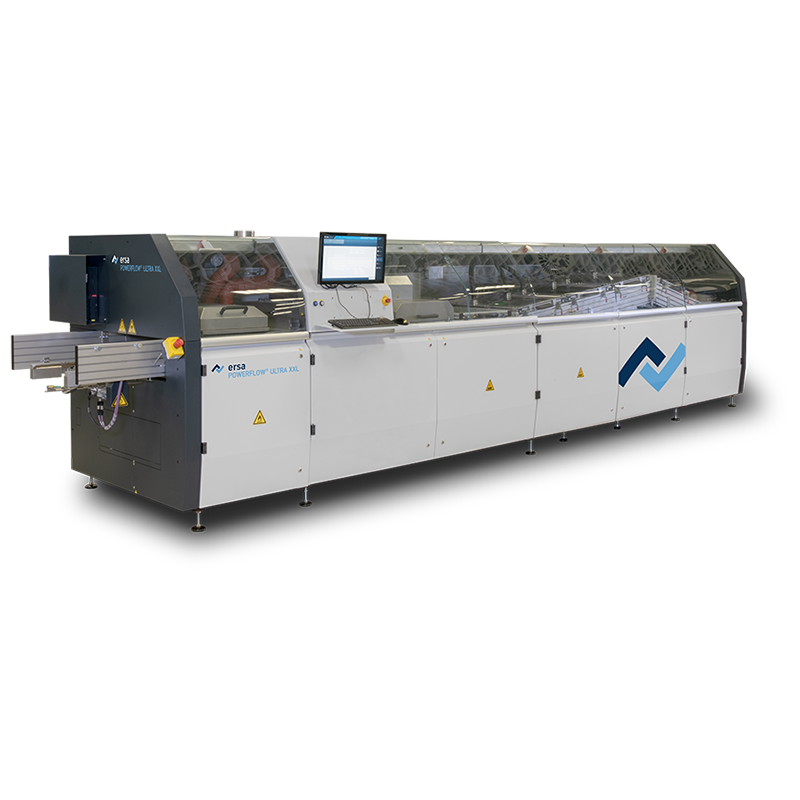
全隧道式氮气波峰焊系统 POWERFLOW ULTRA
-

HR 600/2 返修台
查看更多
-
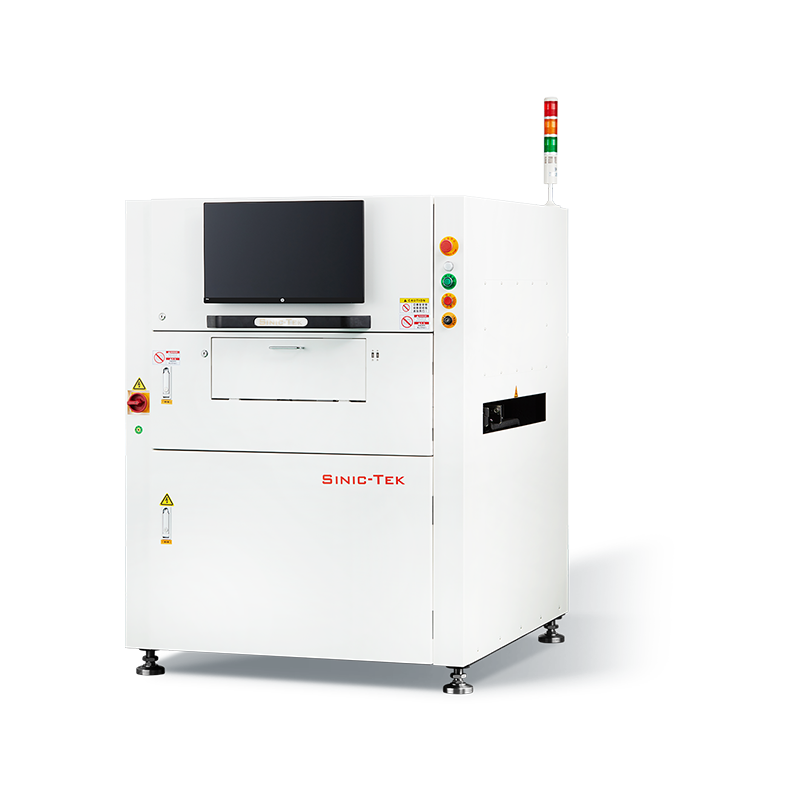
InSPIre-630 在线型高速三维锡膏检测系统
-

S510 在线式2D自动光学检测设备
-
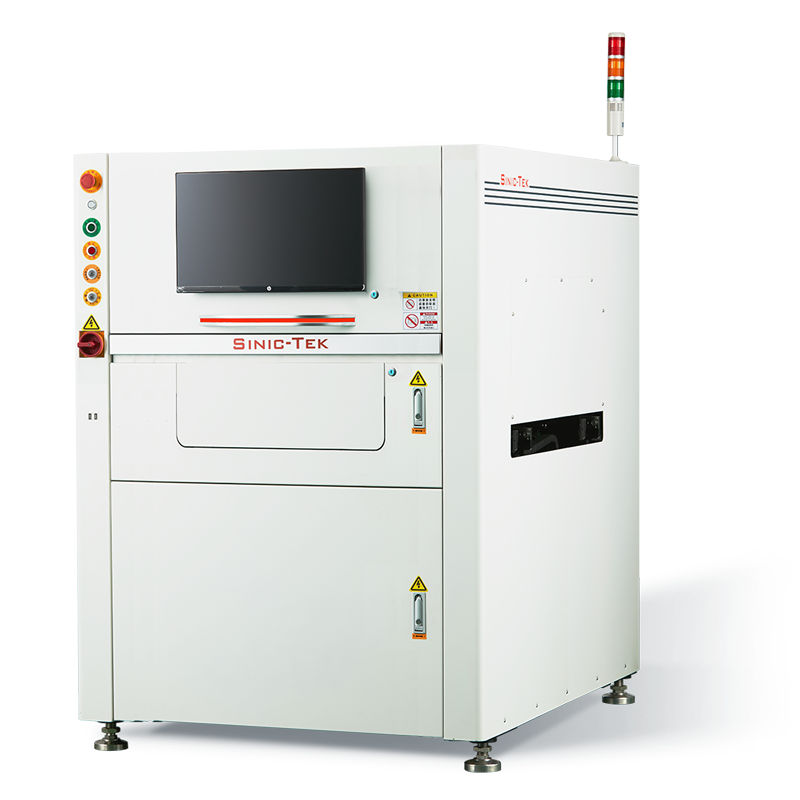
A-630 在线式三维自动光学检测设备
查看更多
-

X射线检测设备 AX9100MAX
-

半导体微聚焦X射线检测设备 AX8300S
-
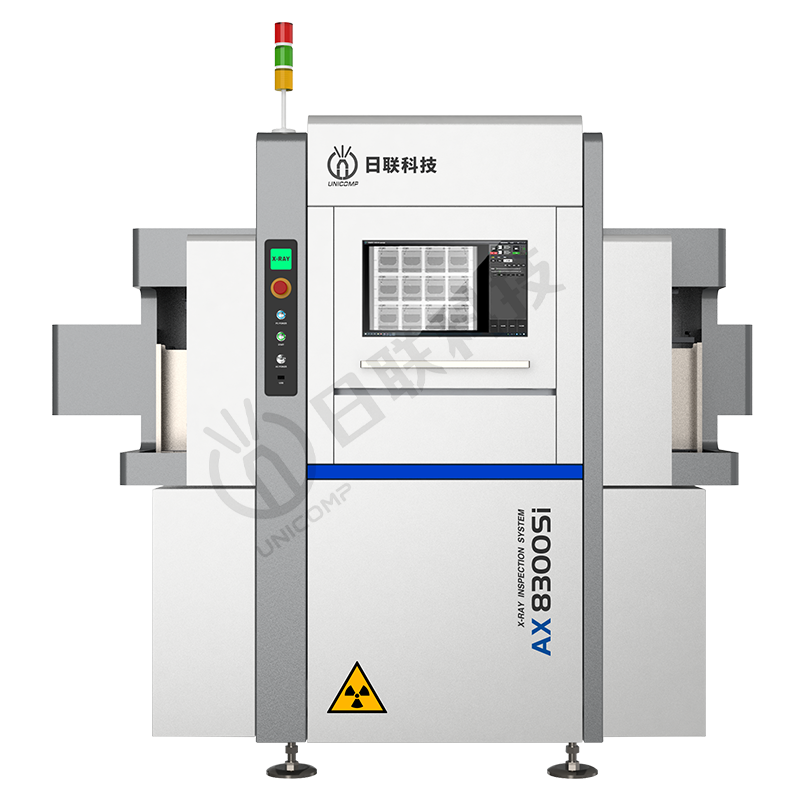
半导体微聚焦X射线检测设备 AX8300Si
-

X射线检测设备 AX9100
-
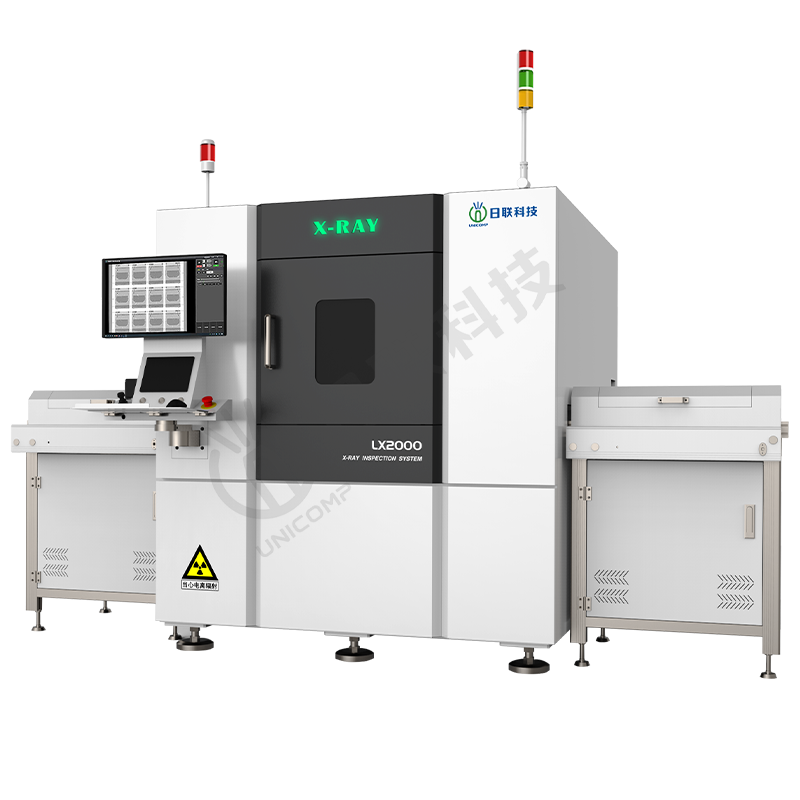
X射线在线检测设备 LX2000
-

3D在线X射线检测设备 LX9200
查看更多
-

智能吸嘴清洗检测一体机
-

全自动吸嘴清洗机
-

全气动钢网清洗机
查看更多
-

单晶圆涂胶机
-
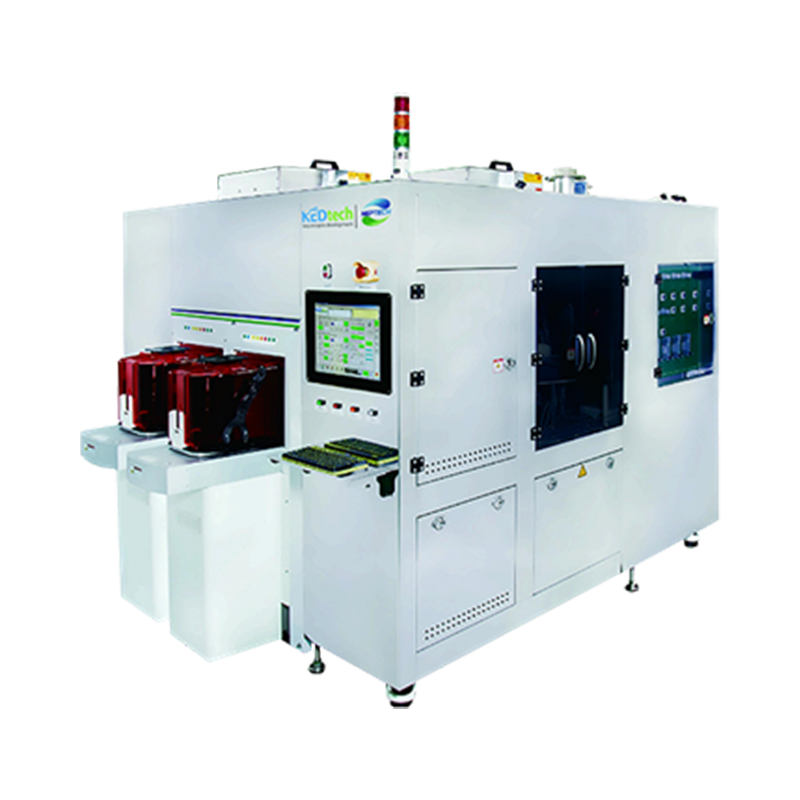
单晶圆清洗机
-

全自动FOUP清洗机
-
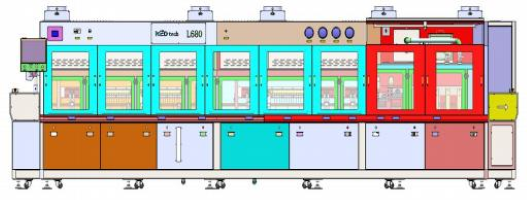
L680在线清洗机
-
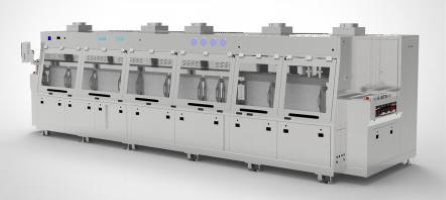
S680在线清洗机
-
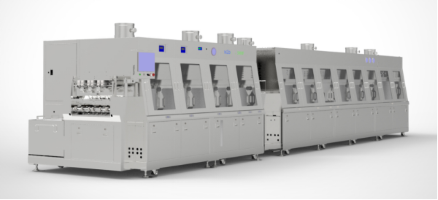
FC-990在线清洗机
查看更多
回流焊波峰焊焊接设备
光学检测设备AOI/SPI
X-ray工业无损检测设备
SMT清洗设备
在线PCBA基板清洗机
产品视频

-
-
解决方案
产品视频

-
关于旻飞
公司简介
查看更多 深圳市旻飞科技有限公司是SMT行业销售和服务的整体方案解决商,我们拥有行业知名SMT设备品牌,如K&S(Assembleon) ,ASM,Ersa等设备的技术和备件维修供应的经验和技术基础,以及设备买卖业务。同时我们公司与合作伙伴共同开发SMT相关的自动化智能产品,提高SMT自动化水平和生产效率。
深圳市旻飞科技有限公司是SMT行业销售和服务的整体方案解决商,我们拥有行业知名SMT设备品牌,如K&S(Assembleon) ,ASM,Ersa等设备的技术和备件维修供应的经验和技术基础,以及设备买卖业务。同时我们公司与合作伙伴共同开发SMT相关的自动化智能产品,提高SMT自动化水平和生产效率。荣誉资质
查看更多 深圳市旻飞科技有限公司是SMT行业销售和服务的整体方案解决商,我们拥有行业知名SMT设备品牌,如K&S(Assembleon) ,ASM,Ersa等设备的技术和备件维修供应的经验和技术基础,以及设备买卖业务。同时我们公司与合作伙伴共同开发SMT相关的自动化智能产品,提高SMT自动化水平和生产效率。
深圳市旻飞科技有限公司是SMT行业销售和服务的整体方案解决商,我们拥有行业知名SMT设备品牌,如K&S(Assembleon) ,ASM,Ersa等设备的技术和备件维修供应的经验和技术基础,以及设备买卖业务。同时我们公司与合作伙伴共同开发SMT相关的自动化智能产品,提高SMT自动化水平和生产效率。发展历程
查看更多 深圳市旻飞科技有限公司是SMT行业销售和服务的整体方案解决商,我们拥有行业知名SMT设备品牌,如K&S(Assembleon) ,ASM,Ersa等设备的技术和备件维修供应的经验和技术基础,以及设备买卖业务。同时我们公司与合作伙伴共同开发SMT相关的自动化智能产品,提高SMT自动化水平和生产效率。
深圳市旻飞科技有限公司是SMT行业销售和服务的整体方案解决商,我们拥有行业知名SMT设备品牌,如K&S(Assembleon) ,ASM,Ersa等设备的技术和备件维修供应的经验和技术基础,以及设备买卖业务。同时我们公司与合作伙伴共同开发SMT相关的自动化智能产品,提高SMT自动化水平和生产效率。产品视频

-
新闻资讯
产品视频

-
联系我们